添加剂吸附对Sn-Ag微凸起形貌的影响(上)
Sn-Ag micro-bumps一直被视作可控塌陷芯片连接(C4)技术中不可或缺的互连结构。这些micro-bumps兼具可靠的电气互连功能以及为电子元件提供机械支撑的双重作用。Sn-(1.5~2.0)wt.%Ag焊料合金因其对Sn晶须生长和大颗粒Ag3Sn合金形成的出色抗性而备受青睐,适用于晶圆凸点工艺。电镀工艺因其成本效益高、操作简便以及在工业规模生产中固有的可扩展性被视为更为优越的制造工艺。
在Sn-Ag bump共沉积电镀溶液中,络合剂是不可或缺的。络合剂与Ag+形成稳定的配位化合物,从而负向移动Ag的平衡电位,并促进Sn与Ag的共沉积过程。金等人使用硫脲或其衍生物作为络合剂,在基于硫酸电镀溶液的环境中制备Sn-Ag合金焊点。然而,仅使用络合剂所获得的电镀溶液所形成的bump形态存在缺陷,如晶粒粗大、平整度低以及致密性差等。因此,有必要选择合适的添加剂以进一步优化镀层形态。
在Sn-Ag电镀溶液中,添加剂可被归类为光亮剂、分散剂和整平剂。光亮剂能够吸附在活性沉积位点上,从而抑制晶核的进一步生长,提高金属沉积的过程电位,并有助于新晶核的形成。因此,光亮剂起到了细化晶粒的作用。鉴于大多数光亮剂均为非极性有机分子,其在水介质中的溶解性有限,因此有必要通过添加分散剂来提高其溶解度。尽管使用了光亮剂,但Sn-Ag bump仍可能显现出中心凹陷和不平整等缺陷因此,需要使用整平剂优先在高电位区域(如边缘edge处)进行吸附,从而抑制边缘处的金属沉积速率并提高bump的微观平整度。因此,优化添加剂的组合浓度对于获得平整度较高的Sn-Ag bump至关重要。
在本研究中,我们开发了一种三元添加剂系统在甲烷磺酸基Sn-Ag电镀工艺中的应用。通过线性扫描伏安法(LSV)和电化学阻抗谱(EIS)对光亮剂和整平剂的吸附机理进行了分析。此外,我们还系统性地考察了添加剂浓度对Sn-Ag micro-bump形貌的影响。
1、实验
一种基底的电镀溶液被采用,该溶液含有甲基甲磺酸锡、甲基磺酸银、间苯二酚、络合剂A以及络合剂B。此处使用了黄酮醇作为光亮剂,试剂X作为整平剂,以及PEO-PPO-PEO作为分散剂。Metrohm VIONIC电化学工作站用于为Sn-Ag合金bump的制造和电化学测量提供恒流电源。阳极是铂金板,而阴极由一个40mmx40mm的die组成,die上有溅射的Cr/Cu/Ni层(粘附/种子/阻挡)。PR图案化定义了micro-bump尺寸(直径80um,高度65um,pitch 150um)。采用三电极系统进行极化曲线测量,以玻碳电极为工作电极,饱和甘汞电极(SCE)为参比电极,铂丝为对电极。电镀过程是在电流密度为8A/dm2、搅拌速度为400rpm的条件下进行。利用扫描电子显微镜(Flex1000 SEM)对Sn-Ag micro-bump的形貌进行了表征。
2、结果与讨论
下图展示了Sn-Ag共沉积过程在不同添加剂浓度(1.0克/升)下的线性扫描伏安特性(LSV)曲线。黄酮醇在更正的电位(-0.4V至-0.5V)处表现出显著的极化效应,导致Sn-Ag合金的起始沉积电位与不含添加剂的溶液相比出现明显负移。相比之下,试剂X在负电位范围(-0.6V至-0.9V)内展现出显著的沉积抑制作用,导致电流显著下降。这两种添加剂的吸附势差异主要归因于它们分子结构上的差异。这种依赖于势的吸附特性使得两种添加剂在调控Sn-Ag bump形态方面展现出协同作用。具体而言,黄酮醇主要影响在较低势位处的成核过程,而试剂X则主要负责在较高势位处的生长控制。
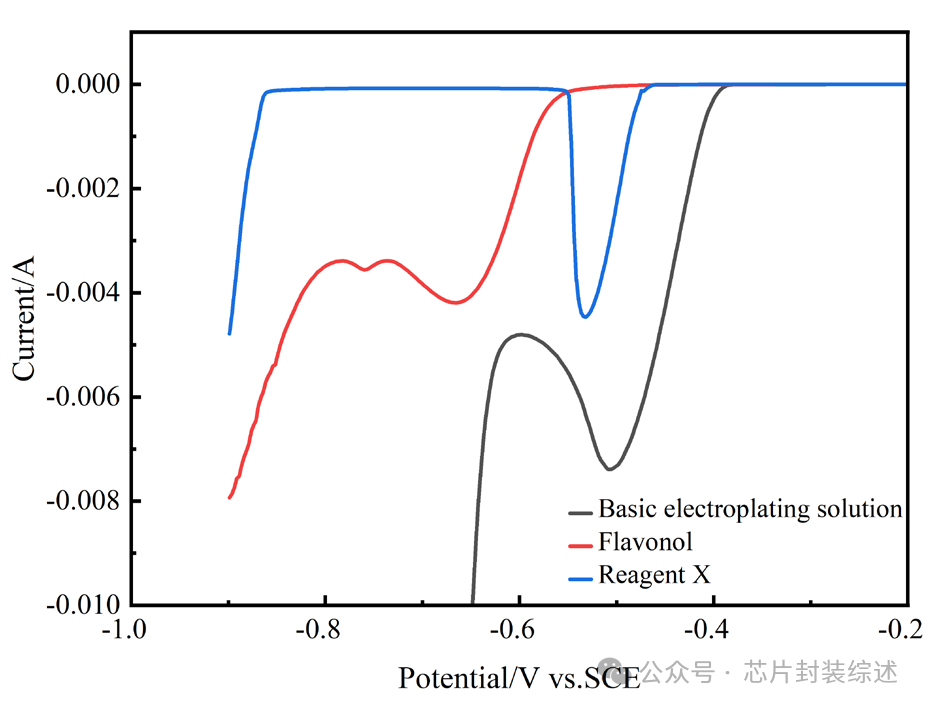
参考文献:[1] Zhang F , Huang F , Yan Y ,et al.Effect of additive adsorption on morphology of Sn-Ag micro-bumps[C]//2025 26th International Conference on Electronic Packaging Technology (ICEPT).0[2026-01-25].
来源:《芯片封装综述》
免责申明:文章版权归原作者所有,如您(单位或个人)认为内容有侵权嫌疑,敬请立即通知我们,我们将第一时间予以更改或删除。





