最近很火的 ECP 是什么?
01 引言
近日,北方华创正式发布公司首款12英寸电镀设备(ECP)—— Ausip T830。该设备专为硅通孔(TSV)铜填充设计,主要应用于2.5D/3D先进封装领域。北方华创的Ausip T830 设备采用高真空密封和电化学沉积技术,实时优化预润湿及电镀参数,实现高深宽比TSV填充。通过优化电场、流场和药液浓度,使TSV内部及边缘的铜沉积均匀,减少缺陷,提高芯片良率和可靠性。其双层双腔架构可同时处理两片晶圆,提高产能,节省空间。定制气缸和密封结构增强稳定性,降低维护成本。智能补液系统减少添加剂用量,助力绿色制造。设备支持模块化定制和后续技术升级,满足多样化需求。目前,该设备的电镀膜厚均匀性满足客户要求,能够有效填充孔直径2-12微米,孔深16-120微米的多种孔型产品。(来自北方华创官方)
那么什么是铜电镀呢?
02 电镀原理
铜电镀(Electrochemical Copper Plating),别名电化学沉积(电化学沉积,Electrochemical Deposition),其实我们都有过接触,例如家里用的水龙头都会镀层铬,来保护龙头不会锈蚀,而在芯片制造领域,电镀主要用来制作铜线,相对于其他沉积方式具有许多优势。

图1 电镀与其他沉积方式的比较(From:ASM)
对于ECD和ECP 的区别: ECD(电化学沉积,Electrochemical Deposition)主要是AMAT/LAM他们这么叫,是比较广义的说法;ECP(电化学铜电镀,Electrochemical Copper Plating) 主要是电镀Cu/Co 国内ACM这些一般这么叫。(来自半导体盒知识星球一位大佬的回答)

图2 TSV 的流程(From:AMAT)
镀铜的概念很简单:将要镀的晶圆浸入电解液中,施加电流,铜离子将迁移并沉积到已有金属种子层的区域。
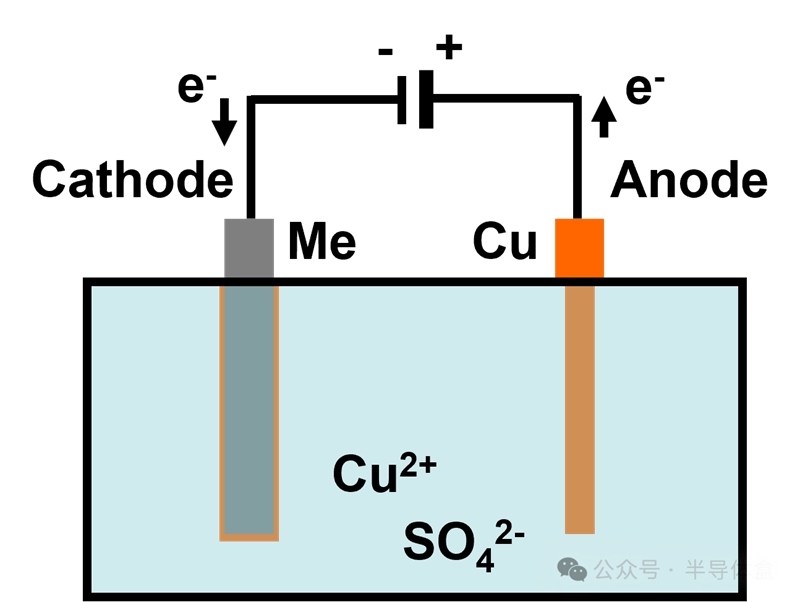
图3 电镀的基本原理
电解液包含三种主要的无机成分:硫酸铜(CuSO4)提供铜离子的来源。硫酸(H2SO4)使镀液导电并充当电荷载体。氯离子(Cl-)与有机物质结合形成络合物,减缓选择性区域的电镀速度。对于先进的封装应用,重要的是要仔细控制镀铜速度和沉积位置。几种有机镀液添加剂有助于达到预期的效果:
a.加速剂形成电活性物质,负责提高电镀速率。
b.抑制剂(Suppressors)与氯离子结合,抑制电镀在需要降低电镀速率的区域,也可以作为润湿剂(wetting agent)。
c.Levelers 使电流密度高的区域极化,使电流分布均匀,并有助于控制表面形态。有机添加剂的作用可能有些不同。
■ 半导体封装中的 Cu 电镀
在几个重要应用中使用铜电镀:双大马士革工艺,硅通孔(TSV),铜柱和铜重新分配层(RDL)。在每种情况下,由不同图案会采用不同的电镀工艺,及主要为添加剂的配比。
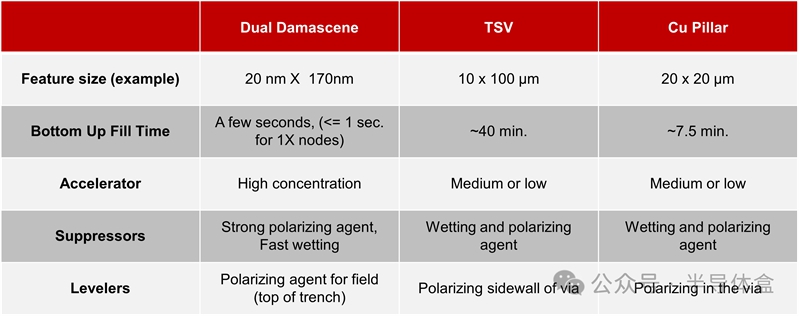
图4 先进封装中的铜电镀应用(From:Dupont)
双大马士革工艺( dual damascene,DD)用于非常小的特征,在几十到几百纳米的范围内,在几秒钟或更短的时间内填充。这需要高浓度的加速器分子底部的槽(Trench)或孔(Via)。抑制剂吸附在侧壁上,抑制侧壁沉积,实现自下而上的充填。矫直机通常保留在顶部表面,减缓过镀速度,使镀层光滑,便于化学机械抛光(CMP)。与 DD 相比,TSV 相对较大,具有更高的深宽比。填充10 μm宽,100 μm深的通孔需要不到60分钟。加速剂到达通孔底部,而抑制剂和 Levelers 都吸附在侧壁和晶圆表面,在那里它们最大限度地减少了形成空洞的风险,并降低了在漫长的电镀过程中过多的 Cu 覆盖。铜柱(pillars)采用不同的制作方法。与 TSV 和 DD 晶圆不同,TSV 和 DD 晶圆在整个晶圆上都涂有铜籽层,而柱晶圆只在底部涂有铜籽层,在顶部涂有光刻胶来制备图案。在7到8分钟的电镀过程中,抑制剂浸湿光刻胶和 leveler 进入孔内,以帮助创建一个平顶柱。leveler 和 Suppressors 都具有极化能力,可以帮助控制不同晶圆片和不同晶圆片上的电镀均匀性。加速剂起 Cu 晶粒细化剂的作用。

图5 先进封装中的铜电镀应用(From:Dupont)
以上内容编译自:Copper electroplating fundamentals-dupont 阅读原文获取更都偶关于 Copper electroplating
03 报告分享
ASM 在 2019年在 iMAPs 2019(International Microelectronics Assembly and Packaging Society)的会议上所作的报告(共34页)。报告以先进封装的发展情况入手,逐步讨论到铜电镀工艺,同时以示例的方式解释在 TSV 中同电镀铜工艺的解决方案。
■ IMAPS is the premier, non-profit membership association steering the communities associated with Microelectronics Advanced Packaging, Interconnect and Assembly by providing channels for communicating, educating, and interacting within academia, industry and government.



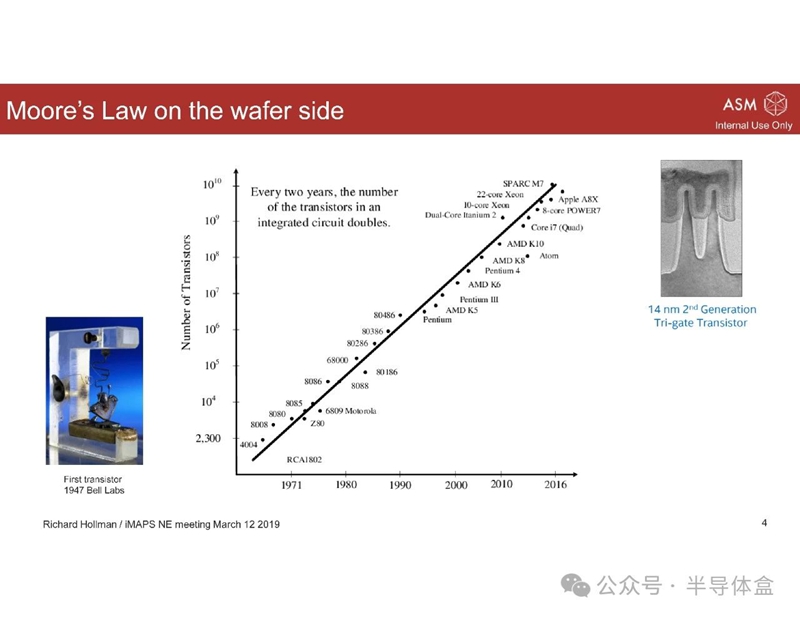
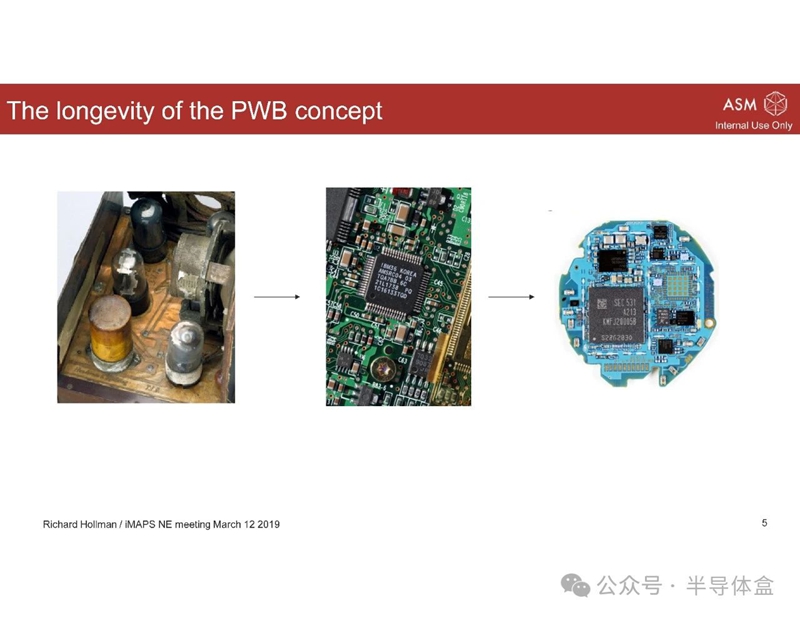
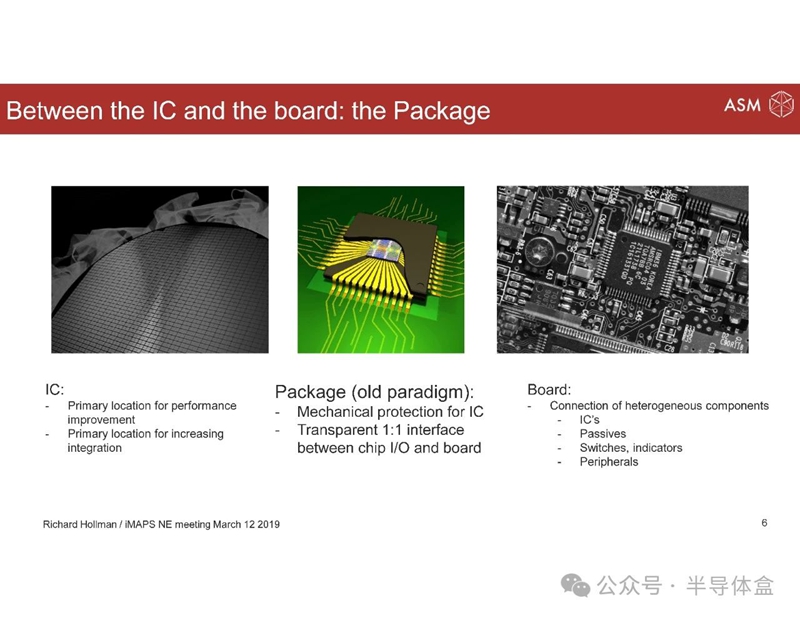

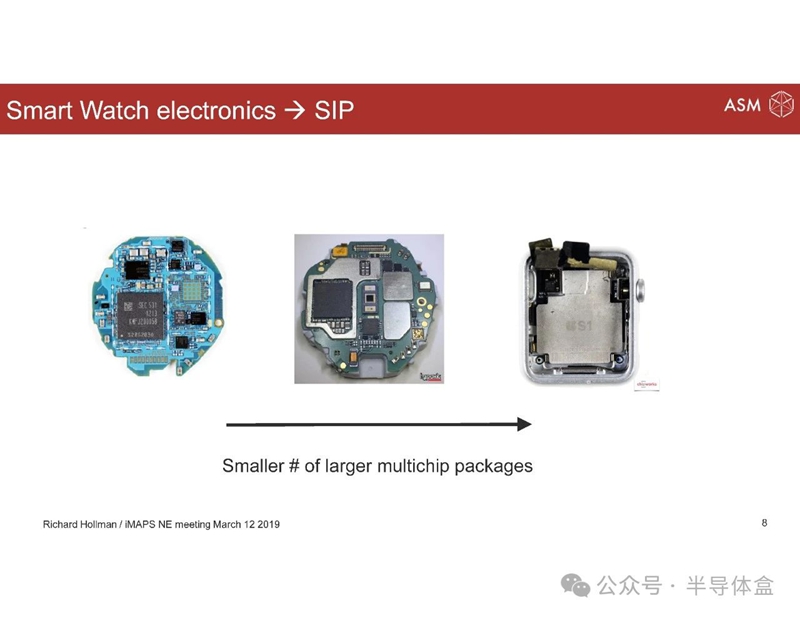


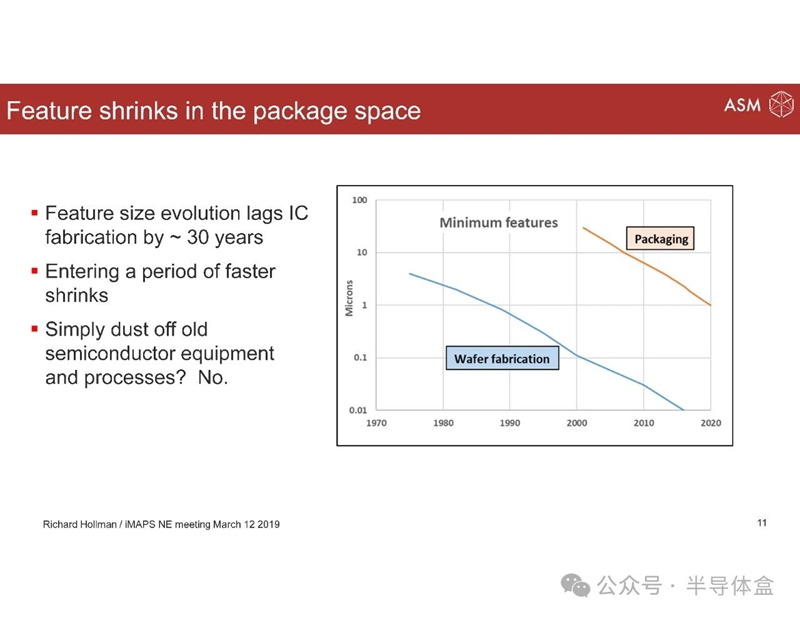


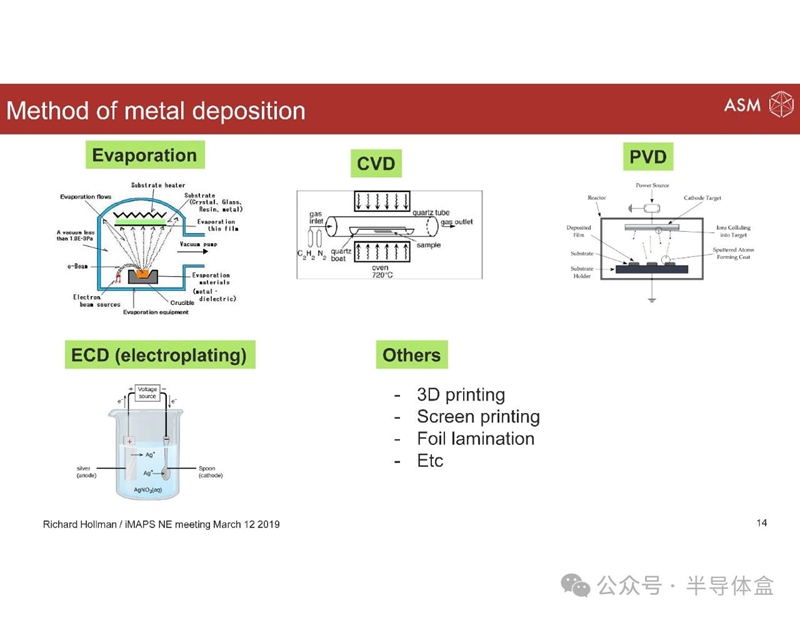



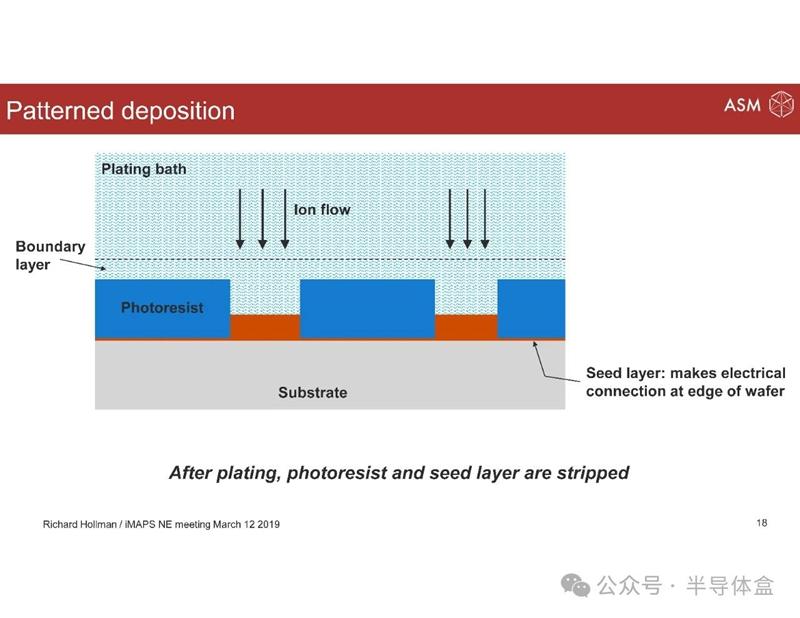
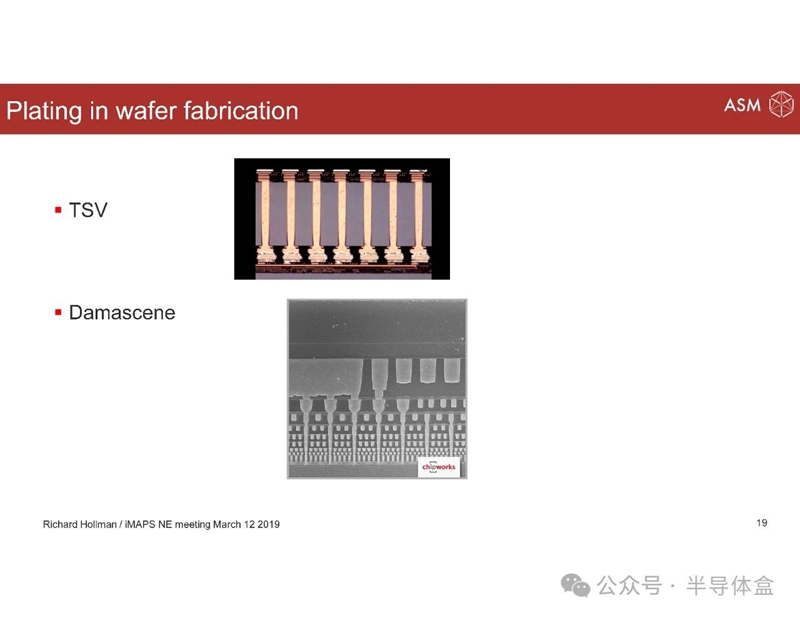
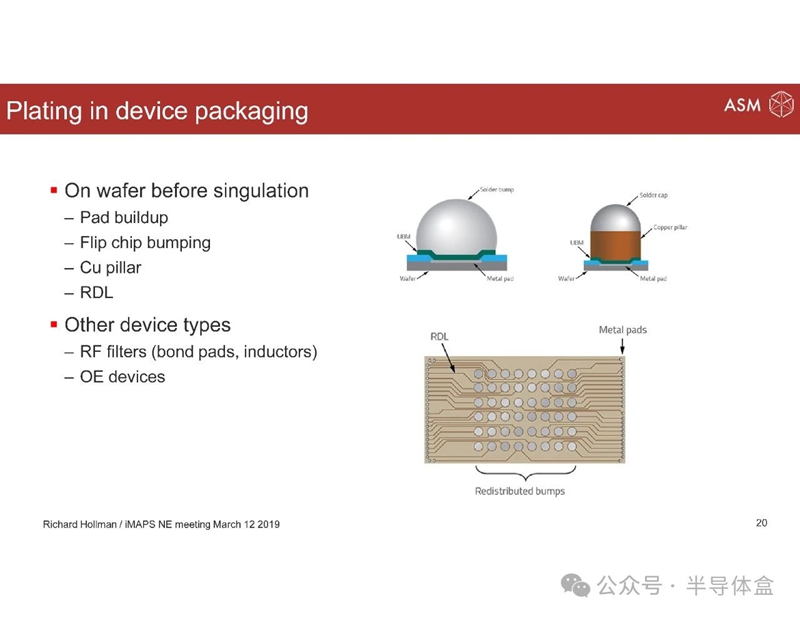
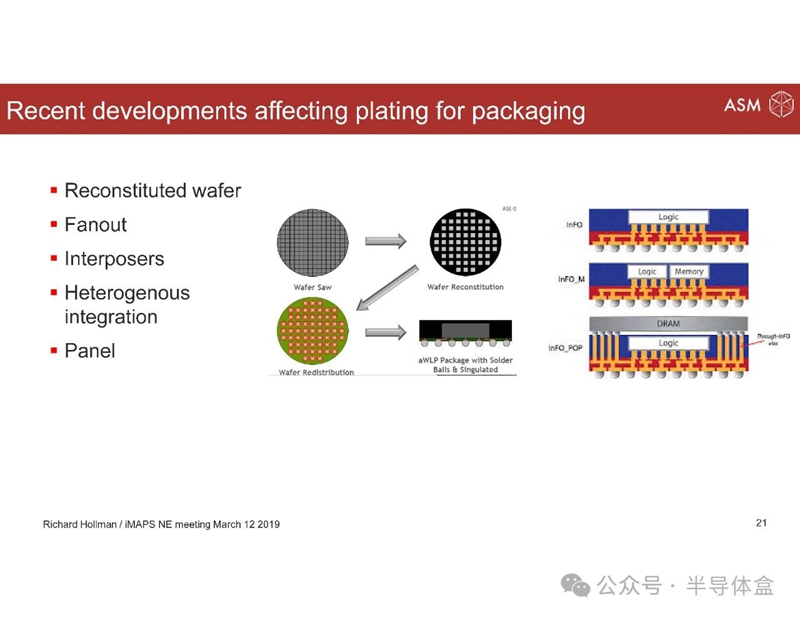
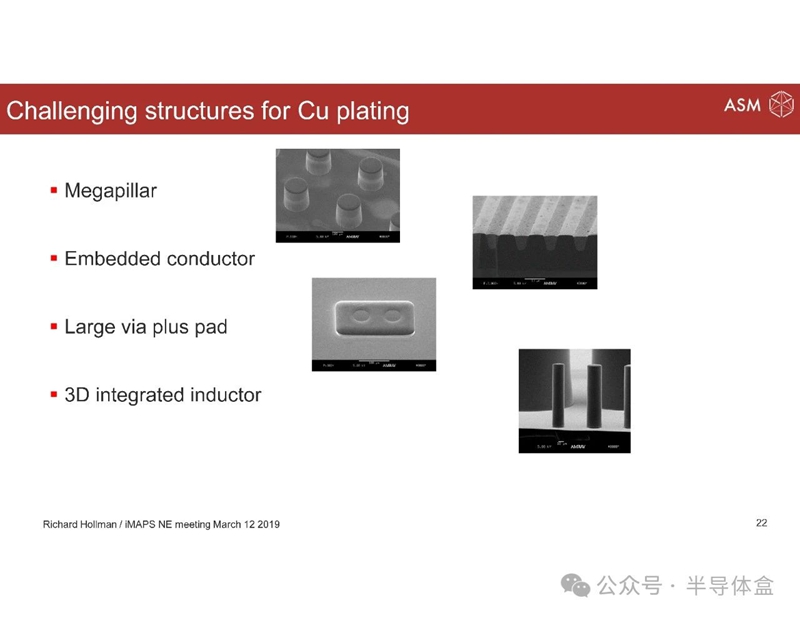

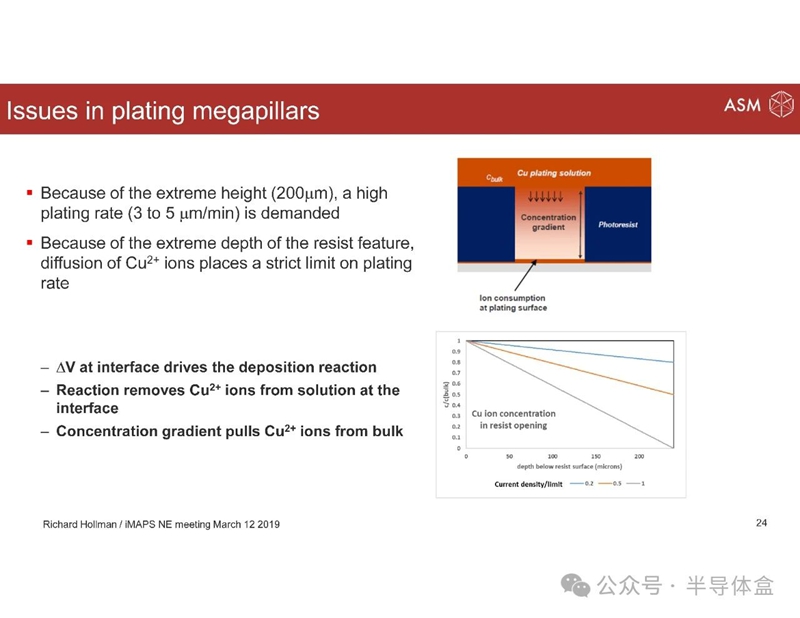

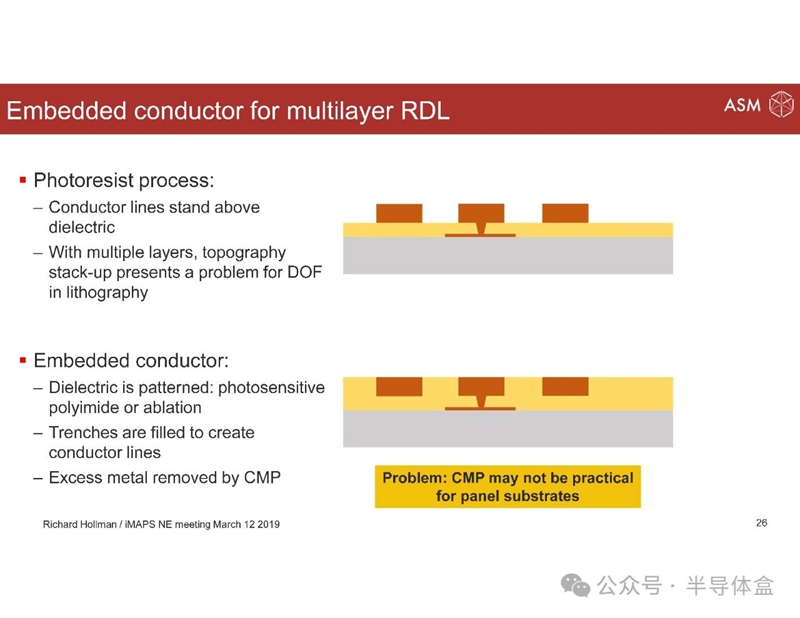
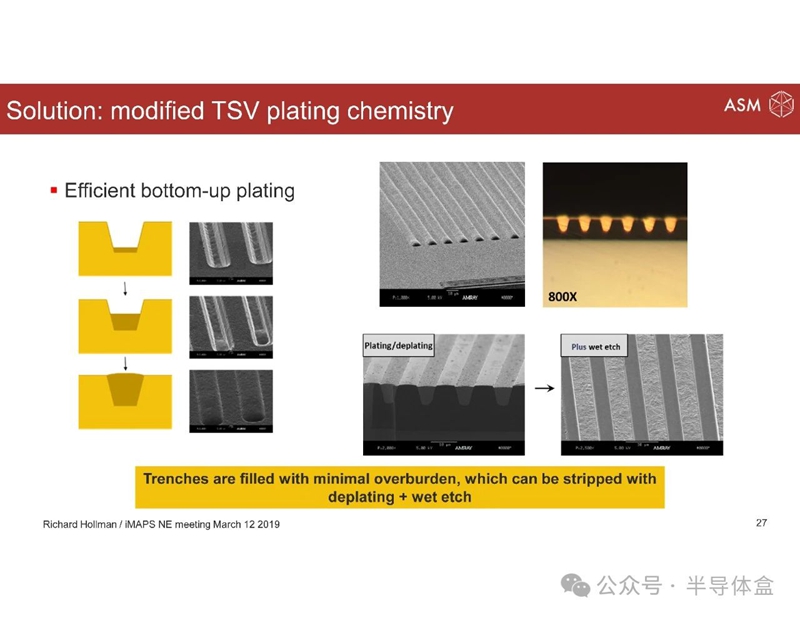
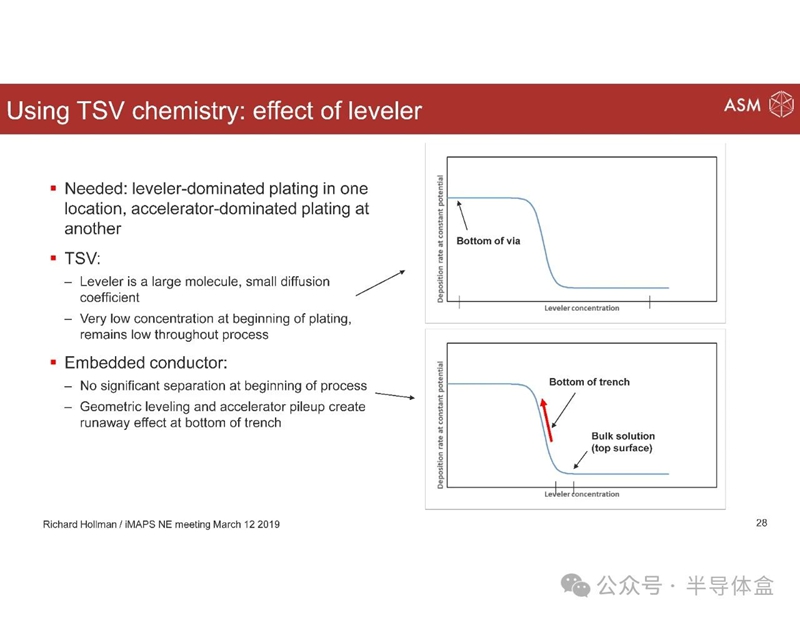
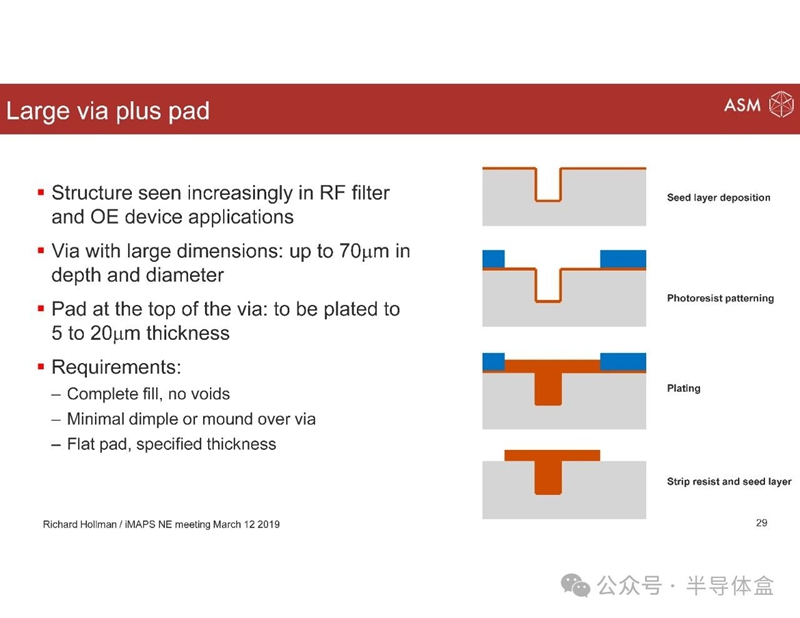
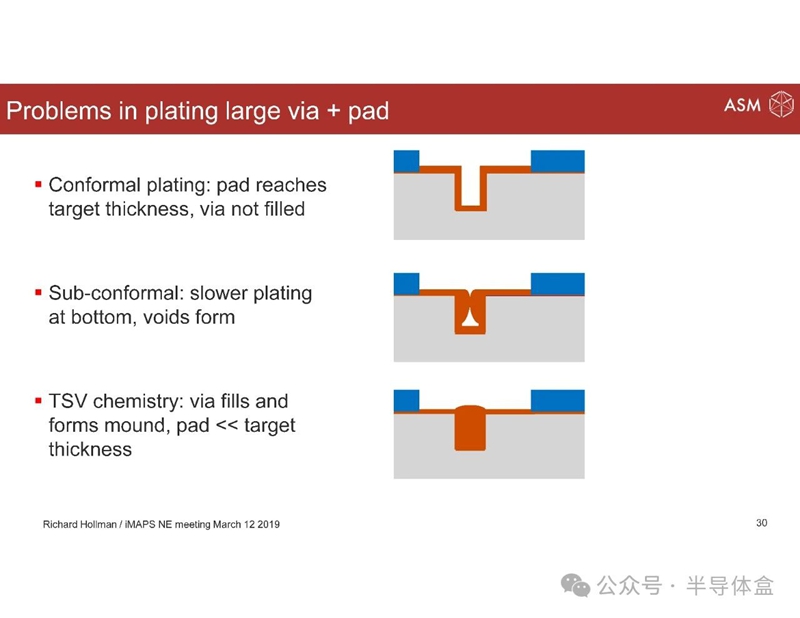
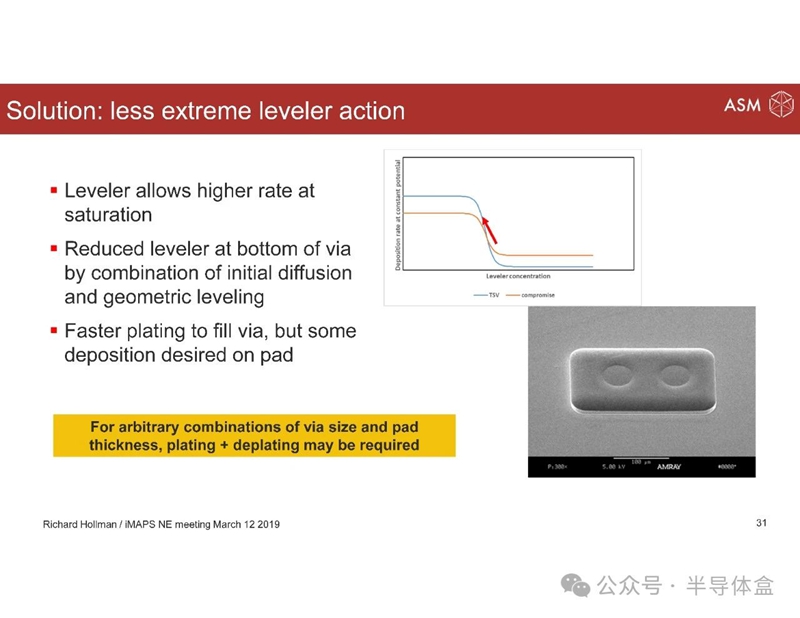


来源:《半导体盒》
免责申明:文章版权归原作者所有,如您(单位或个人)认为内容有侵权嫌疑,敬请立即通知我们,我们将第一时间予以更改或删除。





